AMAT 0100-09145: Technical Specifications
- Component Type
- Category: Gas Flow Controller or Mass Flow Meter (MFM)
- Purpose: Precisely regulates and monitors the flow rate of process gases in semiconductor manufacturing tools.
- Material: Stainless steel (316L) body, fluoropolymer seals (e.g., Kalrez®), and ceramic sensor elements for corrosion resistance.
- Physical Specifications
- Dimensions: Compact design (~150 mm × 80 mm × 50 mm) for integration into gas panels or tool manifolds.
- Weight: 1.2–2.0 kg (optimized for minimal footprint).
- Operating Parameters
- Flow Range: 0.1–1000 sccm (standard cubic centimeters per minute) with ±1% accuracy.
- Pressure Range: 0–100 psig (compatible with high-pressure gas delivery systems).
- Temperature Tolerance: -10°C to 70°C (operational).
- Response Time: <500 ms for full-scale adjustment.
- Gas Compatibility
- Supports inert (Ar, N₂), corrosive (Cl₂, HF), and reactive (O₂, NH₃, WF₆) gases.
- Compatible with ultra-high-purity (UHP) gases (99.999% purity).
- Integration & Control
- Tool Platforms: AMAT Centura®, Endura®, or Producer® platforms.
- Interfaces: Analog (4–20 mA) or digital (RS-485, EtherCAT) communication for integration with tool PLCs.
- Calibration: Field-adjustable via onboard diagnostics or AMAT proprietary software.
- Certifications & Standards
- Complies with SEMI F20-0703 (gas system standards) and SEMI S2/S8 (safety).
- CE/UL certified; RoHS/REACH compliant.
- Lifetime & Maintenance
- Service Life: 5–10 years (dependent on gas aggressiveness and duty cycle).
- Maintenance: Annual calibration; replace seals every 2–3 years.
Functional Overview
The AMAT 0100-09145 is critical for maintaining precise gas flow control in semiconductor fabrication processes, ensuring repeatable and defect-free wafer processing. Key functionalities include:
- Precision Gas Delivery
- Enables sub-nanometer layer uniformity in deposition processes (e.g., ALD, CVD) or precise etch rate control (e.g., plasma etching).
- Feedback loop adjusts flow rates in real time to compensate for pressure/temperature fluctuations.
- Multi-Gas Compatibility
- Engineered for use with aggressive and pyrophoric gases (e.g., SiH₄, WF₆) in advanced logic and memory node fabrication (3nm/5nm).
- Process Stability
- Minimizes flow deviations (<±1%) during critical steps, such as gate oxide formation or spacer etching.
- Reduces particle generation through smooth internal surfaces and laminar flow design.
- Safety Features
- Leak detection algorithms and fail-safe shutoff to prevent hazardous gas releases.
- Compatible with factory-wide gas monitoring systems.
- Applications
- Etch Processes: Controls Cl₂, HBr, or CF₄ flow for anisotropic etches in FinFET or 3D NAND structures.
- Deposition: Manages precursor gases (e.g., TEOS, TMB) for dielectric or metal film growth.
- Chamber Cleaning: Regulates NF₃/O₂ mixtures for in situ plasma cleans.







-480x480.png)


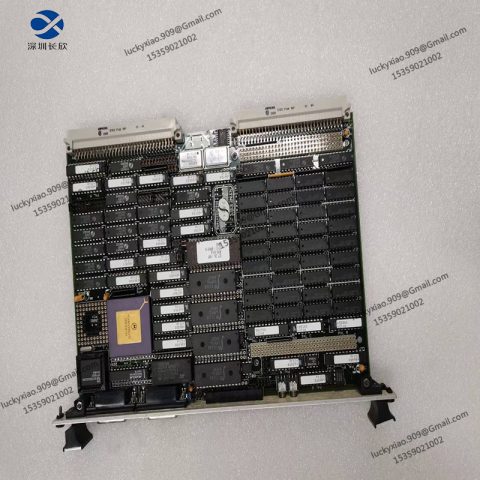
There are no reviews yet.