AMAT 0100-71275: Technical Specifications
- Component Type
- Category: Gas Distribution Assembly or Showerhead Module
- Purpose: Delivers uniform process gas flow into the chamber for deposition (CVD/ALD) or plasma etching.
- Material: Anodized aluminum, quartz, or ceramic-coated stainless steel (corrosion-resistant for aggressive chemistries).
- Physical Specifications
- Diameter: 300–450 mm (matched to 200mm/300mm wafer platforms).
- Thickness: 20–30 mm (multi-zone design for gas distribution).
- Weight: 5–8 kg (optimized for thermal stability and easy handling).
- Operating Parameters
- Flow Rate: 10–1000 sccm per gas channel (adjustable via software control).
- Temperature Range: 50°C to 500°C (compatible with heated gas delivery).
- Pressure Tolerance: Operates from atmospheric pressure to high vacuum (≤ 10⁻⁶ Torr).
- Gas Compatibility
- Supports inert (Ar, N₂), reactive (SiH₄, O₂, NH₃), and corrosive (Cl₂, CF₄, WF₆) gases.
- Coated surfaces prevent particle generation or gas adsorption.
- Integration & Control
- Tool Compatibility: AMAT Centura® or Endura® platforms for etch or CVD processes.
- Control Interface: Integrated with the tool’s PLC for automated flow/pressure adjustments.
- Sensors: Built-in pressure and temperature feedback for real-time gas distribution control.
- Certifications & Standards
- Compliant with SEMI F20 (gas delivery standards) and SEMI S2/S8 (safety).
- REACH/RoHS compliant.
- Lifetime & Maintenance
- Service Life: 5,000–8,000 process hours (depends on gas aggressiveness).
- Maintenance: Quarterly cleaning with plasma (NF₃/O₂) or wet chemistry (HF/H₂O); inspect for clogged gas ports.
Functional Overview
The AMAT 0100-71275 is a critical subsystem for precise gas delivery in semiconductor manufacturing, ensuring uniform processing across the wafer. Key functionalities include:
- Gas Uniformity Control
- Distributes gas evenly through thousands of micro-pores or channels, achieving <±2% film thickness uniformity in CVD/ALD processes (e.g., SiO₂, SiN).
- Plasma Compatibility
- Acts as an RF electrode in plasma-enhanced processes (e.g., PECVD or etch), sustaining stable plasma density for high-aspect-ratio structures.
- Thermal Management
- Maintains temperature uniformity across the showerhead to prevent gas condensation or thermal drift.
- Process Flexibility
- Supports multi-step processes by switching gases dynamically (e.g., alternating precursors for ALD layers).
- Compatible with advanced node requirements (3nm/2nm logic, 3D NAND).
- Applications
- Deposition:
- PECVD of low-k dielectrics or SiCOH films.
- ALD of High-κ oxides (HfO₂, ZrO₂) for gate stacks.
- Etch:
- Uniform gas delivery for anisotropic Si or oxide etching.
- Chamber Cleaning:
- Facilitates NF₃/O₂ plasma cleans to remove chamber deposits.
- Deposition:
Critical Notes
- Safety: Use AMAT-approved protocols for handling gas lines to prevent leaks or cross-contamination.
- Calibration: Regular flow calibration is required to maintain process repeatability.









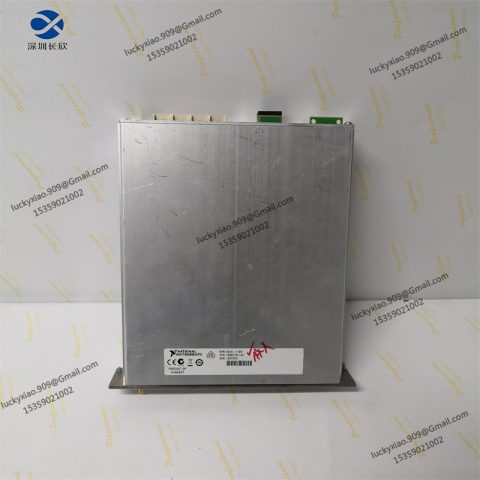
-480x480.jpg)


There are no reviews yet.