AMAT 0190-30354: Technical Specifications
- Component Type
- Category: Temperature Control Module or Thermal Management Subsystem
- Purpose: Regulates wafer or chamber temperature during high-precision processes like annealing, deposition, or curing.
- Material: High-purity silicon carbide (SiC) or aluminum nitride (AlN) for thermal stability and corrosion resistance.
- Physical Specifications
- Dimensions: Compact modular design (~250 mm × 150 mm × 50 mm) for integration into cluster tools.
- Heating Zones: 3–6 independent zones for edge-to-center temperature uniformity.
- Weight: 4–7 kg (lightweight yet rugged for vacuum environments).
- Operational Parameters
- Temperature Range: Ambient to 800°C (with ±0.5°C stability).
- Ramp Rate: Up to 30°C/sec for rapid thermal processing (RTP).
- Power Input: 208–480 VAC, 3-phase, up to 15 kW.
- Cooling: Liquid-cooled (deionized water) for efficient heat dissipation.
- Environmental Compatibility
- Vacuum Operation: Stable in high-vacuum conditions (≤ 10⁻⁷ Torr).
- Gas Compatibility: Resistant to oxidative (O₂), corrosive (Cl₂), and inert (N₂, Ar) environments.
- Integration & Control
- Tool Platforms: Compatible with AMAT Centura® or Producer® systems.
- Sensors: Integrated RTDs (Resistance Temperature Detectors) and thermocouples for real-time feedback.
- Communication: Supports SECS/GEM protocols for automated fab control.
- Certifications & Standards
- Complies with SEMI S2/S8 (safety) and SEMI F47 (power quality).
- RoHS/REACH compliant.
- Lifetime & Maintenance
- Service Life: 5–8 years (depending on thermal cycling frequency).
- Maintenance: Annual inspection of heating elements and calibration of sensors.
Functional Overview
The AMAT 0190-30354 ensures precise thermal control in semiconductor manufacturing, critical for processes requiring nanometer-scale precision. Key functionalities include:
- Uniform Thermal Processing
- Multi-zone heating eliminates temperature gradients, enabling ±1% uniformity for advanced nodes (e.g., 3nm FinFETs).
- Precludes wafer warping during high-temperature steps like epitaxial growth.
- Rapid Thermal Annealing (RTA)
- Enables millisecond-level temperature spikes for dopant activation while minimizing thermal budget.
- Process Stability
- Maintains stable temperatures during deposition (CVD, ALD) or oxide growth, ensuring film uniformity and stoichiometry.
- Energy Efficiency
- Optimized power distribution reduces energy consumption during steady-state operations.
- Applications
- Logic/DRAM: Dopant activation, gate oxide formation, and metal reflow.
- 3D NAND: Thermal cycling for multilayer stack stress relief.
- Advanced Packaging: Reflow soldering and wafer-level bonding.
- Power Devices: High-temperature processing for SiC/GaN semiconductors.








-480x480.jpg)


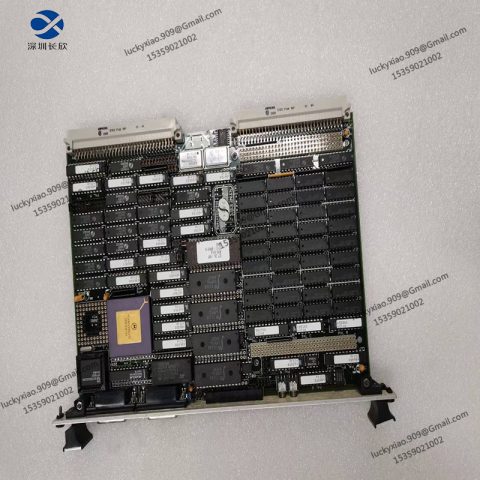
-480x480.jpg)

There are no reviews yet.