AMAT 0190-49518: Technical Specifications
- Component Type
- Category: Process Chamber Heater Assembly or Thermal Control Subsystem
- Purpose: Provides precise temperature control for wafers during high-temperature processes (e.g., anneals, oxidation, or epitaxial growth).
- Material: High-purity quartz, silicon carbide (SiC), or graphite (coated with SiC for contamination resistance).
- Physical Specifications
- Dimensions: Optimized for 200mm/300mm wafer chambers (~300–400 mm diameter).
- Heating Element: Multi-zone resistive heating (e.g., 3–6 zones for uniform thermal distribution).
- Weight: 10–15 kg (integrated with cooling channels for thermal management).
- Operational Parameters
- Temperature Range: 100°C to 1,200°C (adjustable with ±1°C stability).
- Ramp Rate: Up to 50°C/minute (heating and cooling).
- Power Supply: 3-phase AC input, 480V/60A (configurable for global voltage standards).
- Cooling: Water-cooled jacket or gas-assisted quenching for rapid cooldown.
- Environmental Compatibility
- Vacuum Operation: Compatible with base pressure ≤ 10⁻⁶ Torr.
- Gas Environment: Resistant to oxidative (O₂), corrosive (HCl), and reducing (H₂) atmospheres.
- Integration & Control
- Tool Platforms: AMAT Centura® or Vantage® series for thermal processing.
- Sensors: Integrated thermocouples (Type K or C) and RTDs (Resistance Temperature Detectors) for closed-loop feedback.
- Communication: SECS/GEM or Ethernet/IP protocols for integration with fab-wide automation.
- Certifications & Standards
- Complies with SEMI S2/S8 (safety and ergonomic standards).
- RoHS/REACH compliant (hazardous material-free).
- Lifetime & Maintenance
- Service Life: ~5–7 years (depends on thermal cycling frequency).
- Maintenance: Quarterly inspection of heating elements and electrical insulation; annual recalibration of sensors.
Functional Overview
The AMAT 0190-49518 is critical for advanced thermal processing in semiconductor manufacturing, enabling precise control over wafer temperature for high-yield device fabrication. Key functionalities include:
- Uniform Thermal Distribution
- Multi-zone heating compensates for edge-to-center temperature gradients, achieving ±1% uniformity across the wafer.
- Enables defect-free annealing of advanced materials (e.g., SiGe, GaN).
- Rapid Thermal Processing (RTP)
- Supports millisecond-level temperature spikes for ultra-shallow junction formation in logic devices (e.g., 3nm FinFETs).
- Minimizes thermal budget to prevent dopant diffusion.
- High-Temperature Stability
- Maintains stable temperatures during epitaxial growth (e.g., silicon or III-V compounds) or oxidation steps (gate oxide formation).
- Process Flexibility
- Configurable for both batch and single-wafer processing.
- Supports ambient, low-pressure, or inert gas environments.
- Applications
- Front-End Processes:
- Thermal oxidation/nitridation of dielectric layers.
- Activation anneals for ion-implanted dopants.
- Advanced Packaging:
- Reflow soldering for 3DIC structures.
- Wafer-level bonding for MEMS or sensors.
- Power Devices:
- High-temperature epitaxy for SiC or GaN power semiconductors.
- Front-End Processes:
Critical Notes
- Safety: Includes over-temperature interlocks and emergency purge systems to prevent thermal runaway.
- Calibration: Requires periodic alignment with traceable reference sensors to ensure accuracy.










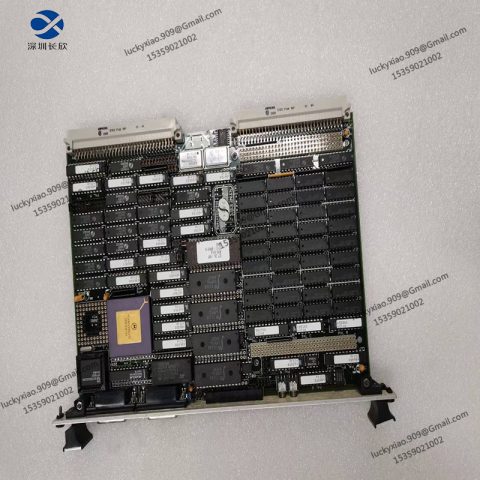


There are no reviews yet.